

最新:ISSCC 2024台积电谈万亿晶体管,3nm将导入汽车
source link: https://www.36kr.com/p/2659541548924036
Go to the source link to view the article. You can view the picture content, updated content and better typesetting reading experience. If the link is broken, please click the button below to view the snapshot at that time.



在ISSCC 2024上,台积电正式公布了其新的先进封装平台,该技术有望将晶体管数量从目前的1000亿提升到1万亿。
台积电业务开发资深副总裁张晓强(Kevin Zhang)在国际固态电路大会ISSCC 2024 介绍公司最新技术,并分享未来技术演进、对于先进制程展望,以及各领域中所需要的最新半导体技术。
Kevin Zhang指出,随着ChatGPT、Wi-Fi 7 出现,已经需要大量半导体,我们也进入半导体高速成长期。在车用部分,汽车产业正经历一场革命,许多人说新的汽车将是定义软件,但他觉得是“硅定义汽车(silicon-defined automotive)”,因为软件需要在硅上运作,推动未来的自动驾驶能力。
本文整理了Kevin Zhang的演讲内容,以飨读者。
从高性能计算、AI机器学习到通信,从交通到医疗保健,凡是目之所及都与半导体相关。Kevin Zhang最开始从商业的角度谈了半导体。

正如我们今天所见,全球半导体收入大约在五千亿美元。业内都认为,到了本十年末,这个数字将翻一番。但Kevin Zhang在这里加上一个限定词:随着人工智能的激增。一万亿数字并不能反映出Open AI的Sam Altman计划投资半导体的数万亿。这个不算最新的预测。AMD的Lisa SU认为,到2028年,仅人工智能市场就能够达到4000亿美元。
Kevin Zhang说到:“没有人能够确切的知道人工智能将如何塑造这条增长曲线。只有一件事能够确定,我们正在进入半导体的加速增长期。”

如果更深入的了解这个潜在的万亿市场的高点,高性能计算将占据40%的份额,超过移动设备成为第一大领域。在几年前,如果说到与物联网结合,那是不可想象的。因为传统观点始终认为,边缘设备是用户消费数据的地方,但是到了现在有了AI。

当谈到AI,那不可避免的需要谈到Chat GPT。自从一年半以前Chat GPT推出以来,我们已经看到半导体行业的格局正在发生变化。
看图上陡峭的曲线,这背后其实是对算力的永不满足。因此,英伟达首席执行官黄仁勋曾说到:“Chat GPT是人工智能的iphone 时刻。”我们可以使用不同的方式描述AI,但确定的是,AI需要大量先进的半导体,这个需求数超越人们的想象。


之后,Kevin Zhang也谈到了无线通信。通信在生活中非常的重要,上图展示了三种通信技术:蜂窝、WI-FI、蓝牙。正如所见,所有高级标准都需要更高的数据速率,更先进的信号处理,这将继续推动加速采用先进的技术,例如Wi-Fi 7。台积电今年也正在着手生产Wi-Fi 7的产品。从一开始,Wi-Fi 7的产品就必须采用7nm技术才能够达到功耗性能目标。


在汽车领域,汽车正在经历一场根本性的革命。很多人认为新汽车将是软件定义汽车,但Kevin Zhang认为更好的术语是:“硅定义汽车(silicon-defined automotive)”。因为所有的软件都必须在硅上运行。无论是传感器、通信、网络都在推动最先进的半导体自主的向前发展技术。


在谈技术前,Kevin Zhang还花费了时间谈到了半导体行业业务的创新——纯代工业务的出现,这项创新从根本上改变了半导体行业的格局。通过从传统的IDM模式中剔除非常复杂、成本高昂的晶圆制造,让无晶圆企业能够专注产品开发和创新。与代工厂的合作,共同极大的加速了行业的创新。

由于代工厂的引入,出现了很多新玩家。快进到2030年,如上图所见,超过50%的半导体收入由优秀的无晶圆公司、系统公司或云公司贡献。这些都是因为业务创新、代工厂的出现。

之后,Kevin Zhang开始谈到了本次演讲的重点:先进技术。Kevin Zhang认为,晶体管仍然是创新的核心,即硅创新(silicon innovation)。几十年来,晶体管经历了多次重大的演变。如上图可见,早期的晶体管创新主要集中在围绕几何减少,但现在情况不再如此。最近一代,一切都集中在晶体管架构的创新以及新材料的使用上。
比如说,16nm将从平面晶体管转向FinFET晶体管。今天,台积电在2nm层面即将推出一种全新的晶体管:Nanosheet。可以极大的改善设备的漏电,提高传导能力,并且在更低的电压下更好的工作。这对于高性能计算来说非常重要。

图案化技术方面,7纳米中,EUV的引入为我们铺平了道路,推动几何缩放向前发展。很多人会问:下一步是什么?Kevin Zhang表示,下一步需要利用Nanosheet,经过几代人的努力获得最佳值,即这个新晶体管的极限。与此同时,台积电也在忙于制造全新的晶体管架构:CFET。本质上,是通过将N-transistor、NMOS和PMOS堆叠在一起,可以将密度大大提高近两倍。
在材料方面,台积电也致力于新材料,例如一种低维材料,通过使用这种新材料,我们可以实现更加节能的目标,远超当今的器件或者晶体管。

进一步了解CFET可以带来的好处,如上图可见,CFET(互补式场效晶体管CFET)是将nMOS和pMOS 垂直堆叠,可大幅改善零组件电流,使晶体管密度提升1.5~2 倍。
这项技术将硅(Si)和锗(Ge)等不同材料从上下方堆叠,使p型和n型的场效晶体管更靠近。通过这种叠加方式,CFET 消除n to p 分开的瓶颈,将运作单元活动区域(cell active area)面积减少2 倍。

Kevin Zhang展示了一张图片,指出这并不是仅仅在PPT上的想法。从上图可以看到,这是台积电实验室制造的真正集成设备,还有晶体管IV优美的曲线。就推动创新而言,这是晶体管架构的一个重要里程碑。

随着晶体管尺寸的缩小,继续缩小晶体管的几何形状变得越来越困难,成本也越来越高。设计师和工程师必须共同努力才能够实现产品层面效益的最佳缩放。因此,台积电经常将其成为设计技术联合组织,或DTCO。
上图展示了一个基于FinFET技术的数学图书馆设计示例。通过使用D-POP技术,减少每个部分的鳍片数量,可以在减小几何尺寸的同时降低功耗。但是当每个设备达到两个鳍片式,设计人员会面临困境。
通过DTCO,台积电的设计和技术团队共同努力,创新的提出了FinFlex的新想法。本质上,允许设计人员混合和匹配单鳍器件、双鳍器件或者双鳍器件和三鳍器件,因此我们可以同时实现最佳的性能、密度和功耗。

另一个很好的例子是SRAM位单元。上图展示了SRAM从130nm一直到今天的3nm,实现了超过100倍的密度提升,这种规模化实际上是流程创新和协作结合的成果,采用更先进的设计技术。

说到SRAM,就不得不谈到最低工作电压,或者说Vmin。在过去很长时间,为了降低电压,必须采用更大的存储单元。通过应用创新的设计技术,我们可以实现超过300毫伏的Vmin改善,这对于低功耗运行非常重要。

技术扩展的本质是为了节能计算。整个半导体行业走了很长一段路。上图展示十年多的规模,台积电实现了超过80倍的能源效率。

关于HPC和AI方面,如果看看今天所有的人工智能加速器,无论是GPU还是TPU或者是定制的ASIC,这些本质上是具有某种特定的集成方案。基本上,使用CowoS技术带来的先进芯片。如今主要是5nm技术和HBM在一起,Kevin Zhang认为这还远远不够。

展望未来,这个平台需要大幅提升以满足高性能计算的需求。因此,这种配置的核心实际上是更高密度、低能耗的计算。需要去栈才能达到计算密度,需要多个最先进的芯片垂直堆叠在一起,以提供所需的计算密度。并且还需要大量的内存,因此需要加入更多的HBM。这就是为什么,硅中介层和CoWoS必须进一步扩展。
这仍然不够,电力传输是一个问题,因此需要集成稳压器才能解决电力输送的挑战。I/O和带宽互联密度也是一个问题,因此需要将硅光子学引入封装中,这就是未来的发展方向。

谈一谈3D堆叠,上图展示了互连密度。我们进行堆叠的原因是为了实现芯片到芯片之间的高密度互连。图中的曲线顶部曲线是SoC,本质上是单片互连。底部曲线是常规封装能够达到的密度。中间部分是CoWoS封装。
谈到3D 堆叠,Kevin Zhang展示一张图,并表示为达到更高的互连密度(Interconnect Density),即Chip To Chip 连结,透过3D 堆叠可以使接合的Pitch 一路缩小到几微米,实现单晶(Monolithic)的互连密度,“所以3D堆叠才是未来”。

谈到硅光子/共封装光学(CPO)方面,Kevin Zhang指出,电子擅长运算,但光子在信号或通信时比较好。他以50T交换机举例,如果全都用电子并采用铜线材质的系统,会烧掉2,400 W。
目前解决方案是采用插拔式模组(Pluggable),可省下40% 功耗(> 1500W),但随着未来需要更高速信号、更大频宽,这远远不够,因此需要把硅光子技术把光子能力带进来。使用共封装光学的先进封装技术来正确实现光子功能。
在图示中,需要用先进堆叠技术,把光子芯片和电子芯片堆叠,可使功耗可再降低50%,约5 皮焦耳(picojoules per bit),使功耗约在850W。

如今,使用最先进的晶体管技术,我们可以将大约1000亿个晶体管封装在同一个芯片中,但这还不足以解决未来的AI机器学习应用。必须利用先进的3D封装技术,才能够将晶体管的数量真正增加到一万亿个,以满足计算需求。

谈到蜂窝射频方面,他提到,当从4G向5G过渡时,为了将数据速率提高十倍,需要结合更多的数字电路,比如先进的ADC、先进的信号处理能力。在这样做时,射频设计、射频收发器设计都可从28nm发展到16nm中收益。
如果展望未来,比如6G,就需要覆盖更广泛的频率范围,与FR3一样需要提高数据速率。这就需要更先进的半导体,因此未来收发器的设计,如果使用7nm、5nm不必感到太过惊讶。


谈到汽车方面,从根本上看,最新的汽车技术需要大量运算能力,但功耗正成为问题,尤其是由电池供电的汽车。
Kevin Zhang认为,车用半导体技术在导入上一直落后消费性或HPC 几个世代,是因为非常需要严格的安全性要求,汽车应用的DPPM(缺陷率)必须接近零,也因此晶圆厂、半导体制造和汽车设计人员必须更密切地合作,以加快这个速度。
台积电正在预先应用自动设计规则降低缺陷密度,Kevin Zhang承诺到:“在不久之后,你们会看到3nm导入汽车。”

谈到MCU方面,MCU在汽车转型为区域架构后变更重要,也需要先进半导体技术给MCU 提供运算能力。传统MCU 大都采用浮动闸极(floating gate)为基础的技术,但浮动闸极技术在28 nm以下就卡关,所幸业界已经投资新内存技术,包括新的非挥发性存储器如磁性随机存取存储器(MRAM)或电阻式存储器(RRAM)。

也因此,从MCU 转移到MRAM、RRAM为基础的技术,有助于推动技术持续微缩,从28 nm缩小到16 nm、甚至是7 nm。

传感器和显示器方面,传感器技术从最简单的2D 设计、单层设计,到现在3D 晶圆堆叠的智能系统,基本上将信号处理层叠在传感层上。Kevin Zhang也表示:“我们技术已经开始投资、研究多层设计的技术。”


进行三层或多层设计能追求画素最佳化,继续推动画素尺寸缩小同时兼顾解析度需求,也能同时达到最佳传感能力;另一个例子是AR、VR,透过将不同层的存储器分开,再堆叠到其他逻辑芯片,可有效缩小尺寸,同时维持高效能需求。
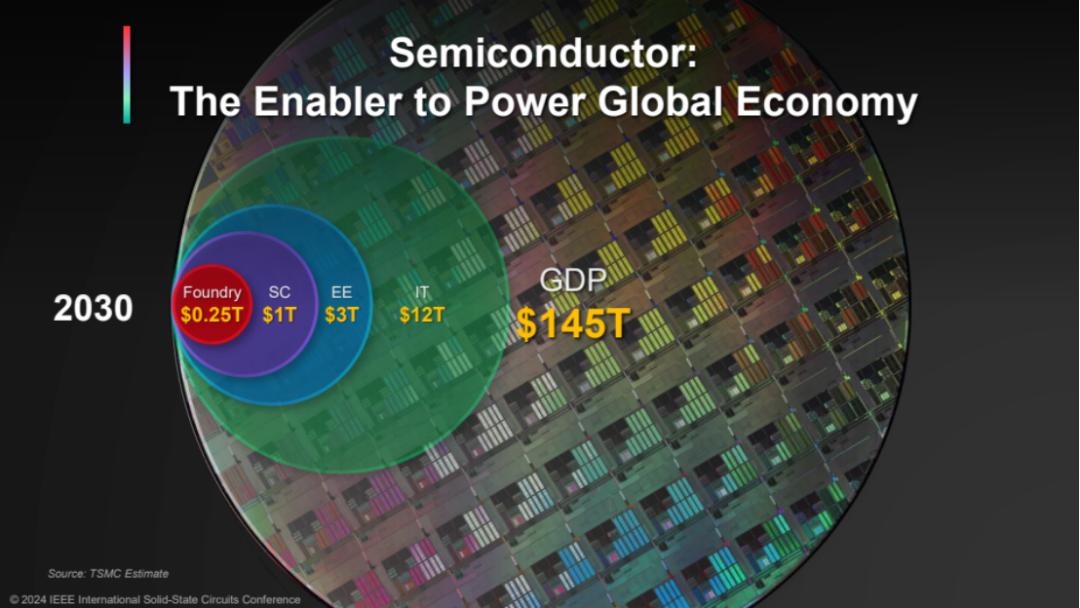
最后Kevin Zhang分享自己的故事,他表示7 年前离开当时最大的半导体公司,去了中国台湾。他离开的时候心想,他的半导体黄金时代已经过去了,去亚洲是要迎接职涯的日落时刻,但时间快转7 年后,他表示:“我没看到日落,而是明亮的日出。随着AI 出现,半导体将驱动许多新应用,触及人类生活每一个面向,并改变人类历史的轨迹,所以我看到明亮、黄金的全新时刻,我们最好的日子还在前头,让我们一起努力使其成真。”
本文来自微信公众号“半导体产业纵横”(ID:ICViews),作者:编辑部,36氪经授权发布。
该文观点仅代表作者本人,36氪平台仅提供信息存储空间服务。
Recommend
About Joyk
Aggregate valuable and interesting links.
Joyk means Joy of geeK